제조 운영 분석 솔루션
빅데이터 등으로 통합해 자동화와 디지털화를 구현하는 게 기존 공장자동화와 차별되는 요소입니다.
이 객체에 각각 지능을 부여하고 이를 사물인터넷(IoT)으로 연결해 자율적으로 데이터를 연결, 수집, 분석하는 공장으로 운영하게 합니다.
YMS
FDC/EPT
RPT
rSPC
Field-oriented
Optimized service



역할의 정의
품질 향상을 위한 통계적 방법을 적용합니다.
2.
문제를 신속하게 해결할 수 있도록 지원합니다.
3.
최적의 작업 조건을 찾고, 이를 통해 공정의 효율성을 높입니다.
실시간 공정 흐름에서의 이상 징후를 모니터링하기 위한 조기 경보 도구
변동성 제어 및 예측 공정 특성을 반영한 분석 기능 제공
제품구성

Field-oriented
Optimized service
실시간 공정 흐름에서 이상 징후를 모니터링하기 위한 조기 경보 도구
변동성 제어 및 예측 공정 특성을 반영한 분석 기능 제공
사용자 친화적
- 개방형 사용자 인터페이스
- 엔지니어의 노하우를 반영한 현장 중심 시스템
데이터 통합
- 제조 공정의 데이터 통합 시스템
- 최적화된 데이터 네트워크
분석 프로세스의 표준화
- 경험에 의존하지 않는 안정적인 분석 품질
- 단순하고 반복적인 작업 제거
- 통계 기법을 통한 분석 능력 향상
지식 기반 워크플로우
- 엔지니어의 노하우를 반영한 워크플로우
Search / Output/ Chart / Batch
Chart (Line / Data /Pie / Bar / Histogram / Pareto / Box / Correlation Matrix )
Lot Link ( Trace , Defect Map ,EDS Map)

- Raw Data Display
- : Line, Eqpid, Time, Item , Subitem, value
- Excel save
- Lot Trace / Wafer Map link
- Field / Raw / Column modify
Chart

FAB Operation Monitoring
Step1 Measure Operation , Step 2 Main Operation
M-P Operation

Inspection Step | Item | Value |
|---|---|---|
Gate Particle | CD01 | 12 |
CD02 | 10 | |
Gate-DEV AOI | Item1 | 10 |
Item2 | 20 | |
Gate-DEV MAR | Item2 | 20 |
Chart

Real Time Warning : Error detection (FAB measurement, DC , EDS data)
Daily Summary : Summary of the results of the previous generation
Real Time Warning

Daily Summary

- Summary of product generated results
- Detail alarm data
- Item , Step chart
Defect Monitoring ( defect size , defect type Chart / total defect Trend), Map , Image
DSA (Defect Source Analysis)

Monitoring

MAP & Image

MAP & Image

EQP Contact

Data Summary : Error detection (FAB measurement, DC , EDS data)
Raw data File : Summary of the results of the previous generation
Data Summary

Raw data file

- DC /EDS Raw data file
- Search : LOTID Like
- Output view & download
운영 데이터의 유의미한 차이 분석(EQPID/PPID/Reticle/Probe Card/PartID/ Foup)
운영 매개변수의 상관 분석 (CD,THK, VT , BIN ..) value
Result & Chart (Summary & raw data , Trend ,X,Y Chart,Bar Chart,Histogram,Box Plot,Pie Chart)
Search & Batch

- Search : Line / term / Process / Partid
- Data Area (FAB(P)/FAB(M)/DC(In-Line)/DC(Final) /EDS(BIN)/EDS(Measure)
Result & Chart

Defect & EDS chip level (BIN , Fail Bit) correlation analysis
Defect Class Kill Ratio , Chart (Bar –Side / Bar-Stacked / H Bar–Side / H Bar-Stacked / Scatter / Line ), Map
Search & Batch

Result & Chart

FAB / Defect / DC / EDS (bin) / EDS (Measure) Map & Chart
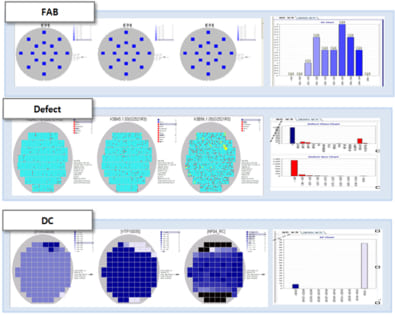
- FAB : Site map , Item Range Bar Chart
- Defect : Defect Class , Size Chart , Defect Image
- DC : Item Range Bar Chart
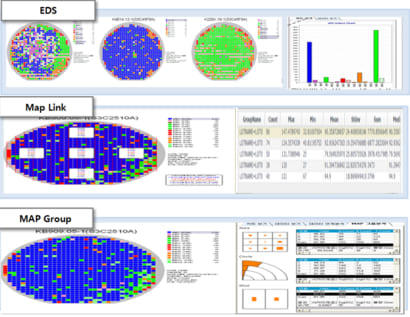
- EDS : BIN, Measure map , BIN , Item Bar Chart
- EDS Map Link : DC . FAB data
- EDS Map Group analysis (AREA, Circle , Shot)
EDA Map Data File (Bin/Measure , Fail Bit) interface
Map (Single, Gallery, Composite ( Lot, Product , FAB_EQPID, FAP_EQPID_LOT)

Monitoring

Bin/Measure Data Wafer/ Lot Trend
Bin/Msr Map

Fail Bit Map

Composite (EQPID)

Measure Chip Chart

User Define Zone (Ring, Line, RingLine, Box, Circle, Select Chip) analysis
EDS BIN,MSR (AVG, std, median, sum, Min , Max , FAB Defect Code Defect Density)
Zone Analysis

Map Search
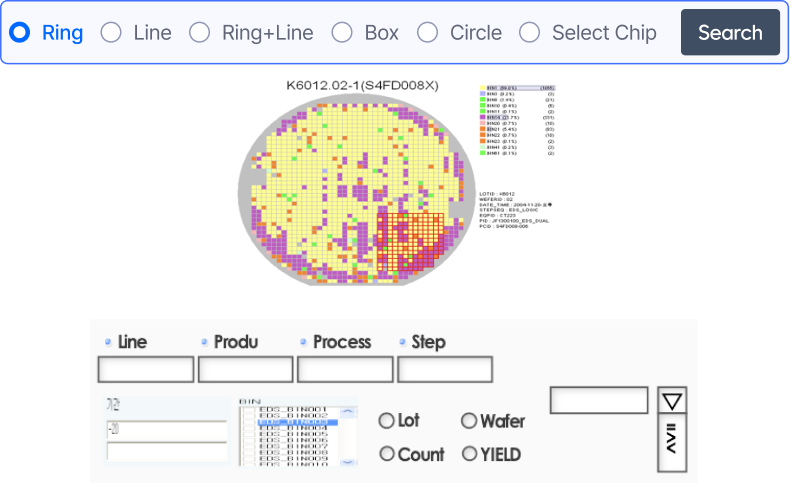
LOT1 | Wafer2 | product | 70% | 2017-05-21 |
LOT2 | Wafer1 | product | 70% | 2017-05-21 |
Lot Group
Commonality
양방향 배치 추적 및 트레이싱
배치에 대한 모든 정보 제공 (이벤트, 추적, FAB(측정), DC, EDS, Material , Comment)
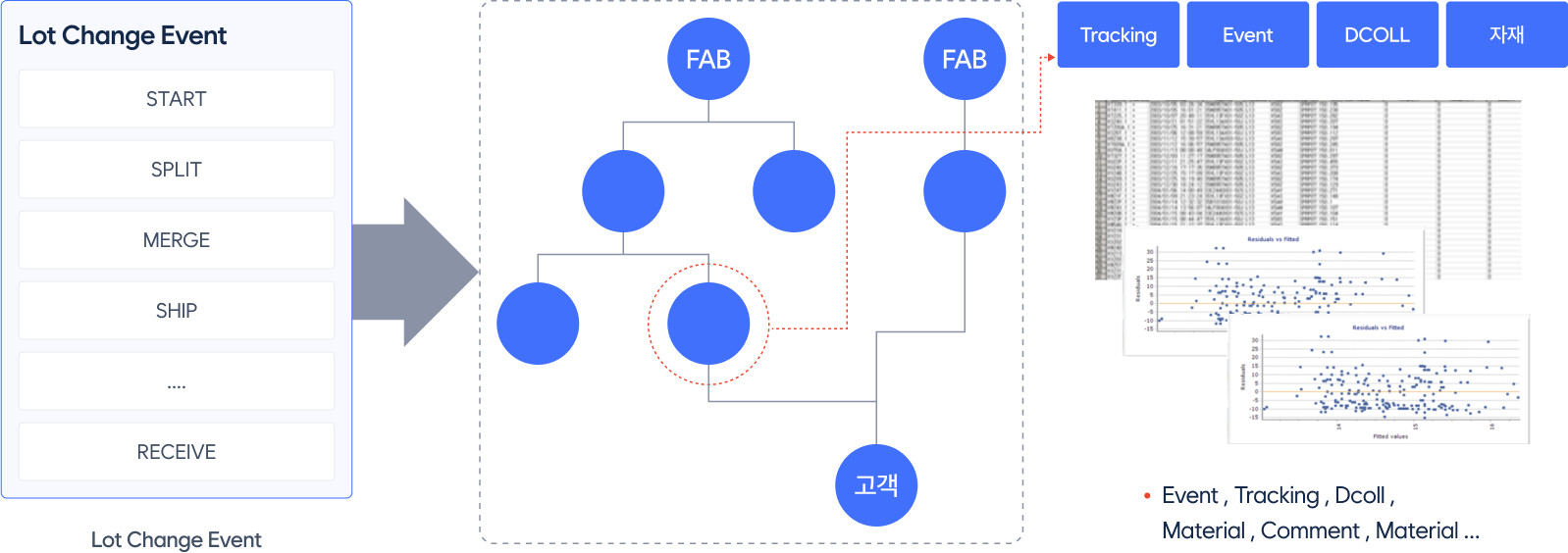
EIN (Engineer Inform Notification) Lot/Wafer Data I/F
FAB / DC / EDS Evaluation Chart & Report, Mail
Select & Analysis
Result & Chart
PARTID | LOTID | STEP | Wafer ID | DESC | YIELD |
|---|---|---|---|---|---|
S3PART | KOLT.1 | 150000 | #12,1,3,4,6,7,8 | NORMAL | 91.2 |
#2,5,8, 11, 14, 17,20,23 | EIN (CP01 CH_B, P-chuck) | 90.2 |
LOTID | STEP | ITEMID | Normal | EIN | P. value | LSL | TARGET | USL | ||||
|---|---|---|---|---|---|---|---|---|---|---|---|---|
CntWF | AVG | STD | CntWF | AVG | STD | |||||||
0853.1 | 6150000 | CD1 | 2 | 2 | 0.2 | 2 | 2 | 0.2 | 0.1 | 1 | 2 | 3 |
LOTID | STEP | SPLIT Group | 0_0 | 1_PC | 2_BG | 53_Malbalgub | K0853 | 2A0076R6 | NORMAL | 2 | 11 | 3 | 1 |
|---|---|---|---|---|---|---|
EIN (CP801 CH_B, P-chuck) | 1 | 2 | 4 |
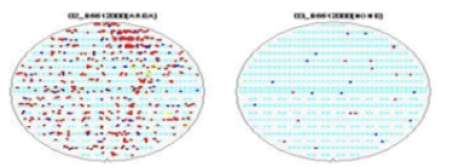

EQP 공통성: 불량 배치 그룹에서 공통 장비 검색
파라미터 유의한 차이: 두 그룹(BAD, GOOD Lot) 간의 항목(Fab, DC) 검색
Search & Batch
EQP Commonality
- EQP Progress
- Time difference
- EQP Path
Significant difference
- FAB (measure)
- DC
Result & Chart


Search Engine : 환경 접근 및 비구조적 탐색을 위한 자유로운 데이터 접근
Data Type : FAB (M), FAB(P), EDS Bin , DC , NonLOT, Comment , Material …

Chart & Output

제품지원
UMS
- 소프트웨어 유지보수(software maintenance) 를 위한 배포된 이후 결함을 수정하고 성능이나 기타 특성을 개선하는 및 제품의 수정을 위한 UMS Center 운영
운영교육
- 제품 배포 후 운영을 위한 시스템 관리자 매뉴얼 제공
- 관리자를 위한 제품 교육
- 운영 체제 관리, 운영 체제의 일상적인 유지보수를 위한 전담 제품 관리 Center 운영
제품지원
- 제품 업데이트 기능 서비스
- 사용자를 위한 온라인 매뉴얼 및 사용설명
- 제품 관련 의견/ 제안을 할 수 있는 온라인 소통공간 서비스