Manufacturing Operations Analysis Solution
It integrates IoT, AI, and big data to enable automation and digitization, going beyond traditional factory automation.
These objects are equipped with intelligence and linked via IoT to power seamless data connection, collection, and analysis for autonomous operations.
YMS
rSPC
FDC/EPT
RPT
Field-oriented
Optimized service



What does it do?
2.
3.
Features early warning tools that monitor abnormal signs in real-time process flows.
Provides analytical functions that incorporate variability control and predictive process characteristics.
Product Configuration

Field-oriented
Optimized service
Features early warning tools that monitor abnormal signs in real-time process flows.
Provides analytical functions that incorporate variability control and predictive process characteristics.
User-friendly
- Open user interface
- Field-oriented system that incorporates engineers' expertise
Data integration
- Comprehensive data integration system for manufacturing processes
- Optimized data network
Standardized analysis process
- Consistent analysis quality without reliance on individual experience
- Eliminates simple and repetitive tasks
- Analytical capabilities enhanced using statistical techniques
Knowledge-based workflows
- Workflows that incorporate engineers' expertise
Search / Output/ Chart / Batch
Chart (Line / Data /Pie / Bar / Histogram / Pareto / Box / Correlation Matrix )
Lot Link ( Trace , Defect Map ,EDS Map)

- Raw Data Display
- : Line, Eqpid, Time, Item , Subitem, value
- Excel save
- Lot Trace / Wafer Map link
- Field / Raw / Column modify
Chart

FAB Operation Monitoring
Step1 Measure Operation , Step 2 Main Operation
M-P Operation

Inspection Step | Item | Value |
|---|---|---|
Gate Particle | CD01 | 12 |
CD02 | 10 | |
Gate-DEV AOI | Item1 | 10 |
Item2 | 20 | |
Gate-DEV MAR | Item2 | 20 |
Chart

Real Time Warning : Error detection (FAB measurement, DC , EDS data)
Daily Summary : Summary of the results of the previous generation
Real Time Warning

Daily Summary

- Summary of product generated results
- Detail alarm data
- Item , Step chart
Defect Monitoring ( defect size , defect type Chart / total defect Trend), Map , Image
DSA (Defect Source Analysis)

Monitoring

MAP & Image

MAP & Image

EQP Contact

Data Summary : Error detection (FAB measurement, DC , EDS data)
Raw data File : Summary of the results of the previous generation
Data Summary

Raw data file

- DC /EDS Raw data file
- Search : LOTID Like
- Output view & download
Analysis of significant differences in operational data (EQPID/PPID/Reticle/Probe Card/PartID/Foup)
Correlation analysis of operational parameters (CD, THK, VT, BIN, etc.) value
Result & Chart (Summary & raw data , Trend ,X,Y Chart,Bar Chart,Histogram,Box Plot,Pie Chart)
Search & Batch

- Search : Line / term / Process / Partid
- Data Area (FAB(P)/FAB(M)/DC(In-Line)/DC(Final) /EDS(BIN)/EDS(Measure)
Result & Chart

Analysis of significant differences in operational data (EQPID/PPID/Reticle/Probe Card/PartID/Foup)
Correlation analysis of operational parameters (CD, THK, VT, BIN, etc.) value
Result & Chart (Summary & raw data , Trend ,X,Y Chart,Bar Chart,Histogram,Box Plot,Pie Chart)
Search & Batch

- Search : Line / term / Process / Partid
- Data Area (FAB(P)/FAB(M)/DC(In-Line)/DC(Final) /EDS(BIN)/EDS(Measure)
Result & Chart

Defect & EDS chip level (BIN , Fail Bit) correlation analysis
Defect Class Kill Ratio , Chart (Bar –Side / Bar-Stacked / H Bar–Side / H Bar-Stacked / Scatter / Line ), Map
Search & Batch

Result & Chart

FAB / Defect / DC / EDS (bin) / EDS (Measure) Map & Chart
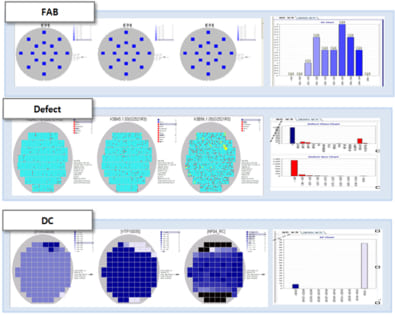
- FAB : Site map , Item Range Bar Chart
- Defect : Defect Class , Size Chart , Defect Image
- DC : Item Range Bar Chart
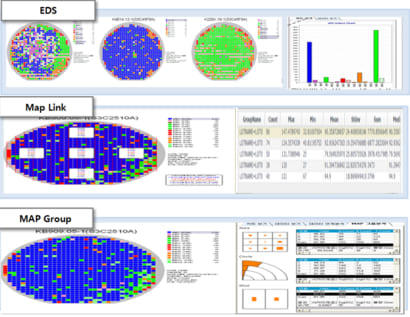
- EDS : BIN, Measure map , BIN , Item Bar Chart
- EDS Map Link : DC . FAB data
- EDS Map Group analysis (AREA, Circle , Shot)
EDA Map Data File (Bin/Measure , Fail Bit) interface
Map (Single, Gallery, Composite ( Lot, Product , FAB_EQPID, FAP_EQPID_LOT)

Monitoring

Bin/Measure Data Wafer/ Lot Trend
Bin/Msr Map

Fail Bit Map

Composite (EQPID)

Measure Chip Chart

User Define Zone (Ring, Line, RingLine, Box, Circle, Select Chip) analysis
EDS BIN,MSR (AVG, std, median, sum, Min , Max , FAB Defect Code Defect Density)
Zone Analysis

Map Search
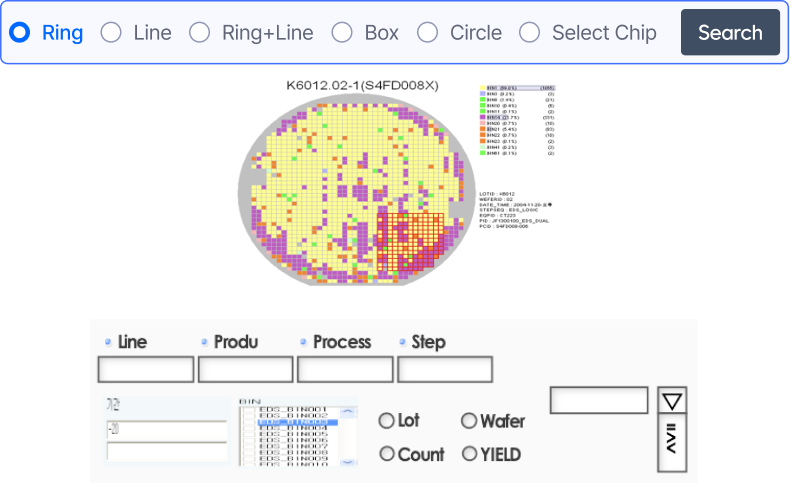
LOT1 | Wafer2 | product | 70% | 2017-05-21 |
LOT2 | Wafer1 | product | 70% | 2017-05-21 |
MAP Link
Lot Group
Commonality
Bi-directional batch tracking and tracing
Provides comprehensive information about batches (Events, tracking, FAB (measurements), DC, EDS, material, comments)
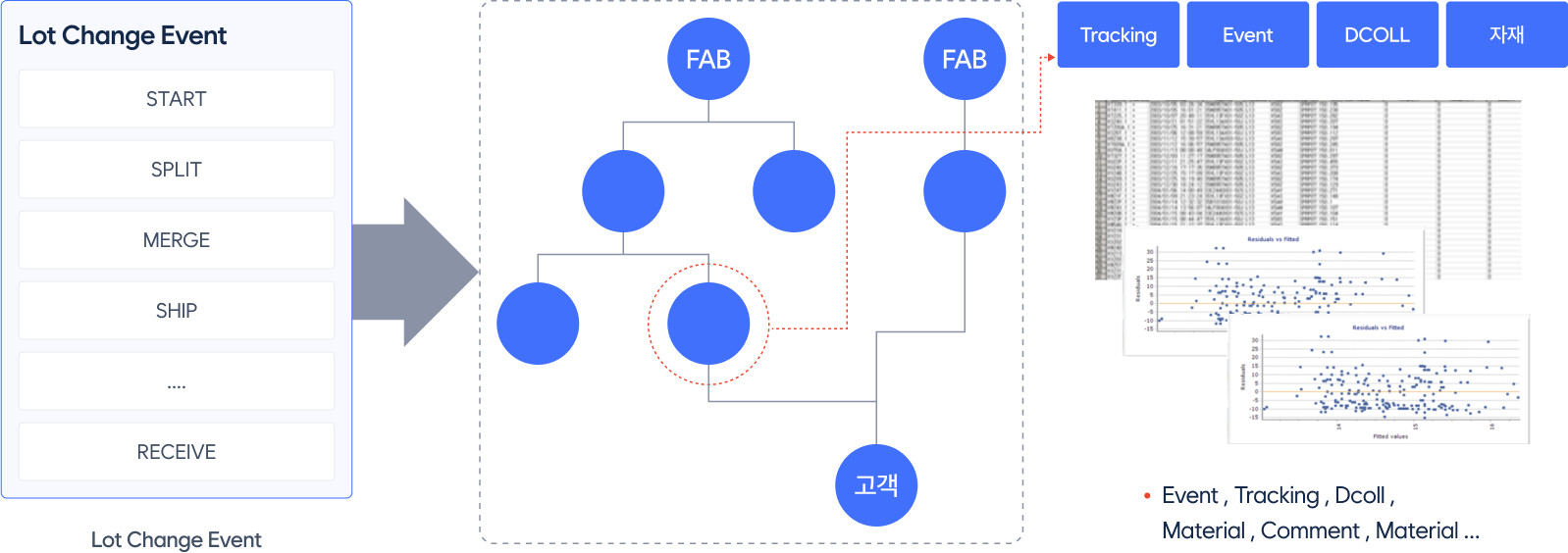
EIN (Engineer Inform Notification) Lot/Wafer Data I/F
FAB / DC / EDS Evaluation Chart & Report, Mail
Select & Analysis
Result & Chart
PARTID | LOTID | STEP | Wafer ID | DESC | YIELD |
|---|---|---|---|---|---|
S3PART | KOLT.1 | 150000 | #12,1,3,4,6,7,8 | NORMAL | 91.2 |
#2,5,8, 11, 14, 17,20,23 | EIN (CP01 CH_B, P-chuck) | 90.2 |
LOTID | STEP | ITEMID | Normal | EIN | P. value | LSL | TARGET | USL | ||||
|---|---|---|---|---|---|---|---|---|---|---|---|---|
CntWF | AVG | STD | CntWF | AVG | STD | |||||||
0853.1 | 6150000 | CD1 | 2 | 2 | 0.2 | 2 | 2 | 0.2 | 0.1 | 1 | 2 | 3 |
LOTID | STEP | SPLIT Group | 0_0 | 1_PC | 2_BG | 53_Malbalgub | K0853 | 2A0076R6 | NORMAL | 2 | 11 | 3 | 1 |
|---|---|---|---|---|---|---|
EIN (CP801 CH_B, P-chuck) | 1 | 2 | 4 |
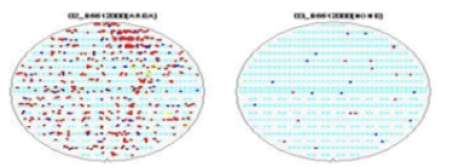

EQP commonality: Searches for common equipment within defective batch groups.
Significant parameter differences: Searches for items (Fab, DC) between two groups (BAD Lot and GOOD Lot)
Search & Batch
EQP Commonality
- EQP Progress
- Time difference
- EQP Path
Significant difference
- FAB (measure)
- DC
Result & Chart


Search Engine: Enables flexible data access for environmental exploration and unstructured searches.
Data Type : FAB (M), FAB(P), EDS Bin , DC , NonLOT, Comment , Material …

Chart & Output

Product Support
UMS
- Providing comprehensive software maintenance through the UMS Center, addressing defect fixes, performance enhancements, feature improvements, and product updates after deployment
Operational Training
- System administrator manual provided for smooth post-deployment operations
- Product training for administrators
- Dedicated Product Management Center to oversee operating systems and handle routine maintenance
Product Support
- Product updates
- Online manuals and user guides
- Online platform for sharing feedback and suggestions related to the product